
Technology Leadership
ASE is a primary architect of Heterogeneous Integration (HI)
Our technologies have enabled our customers to create cutting edge products that deliver superior performance, power, speed, and connectivity.
more about HI









Markets Enabled by ASE and Semiconductors
Applications fueled by Semiconductor Innovation

Sustainability Drives the Future
We are building a better world.

Press Center
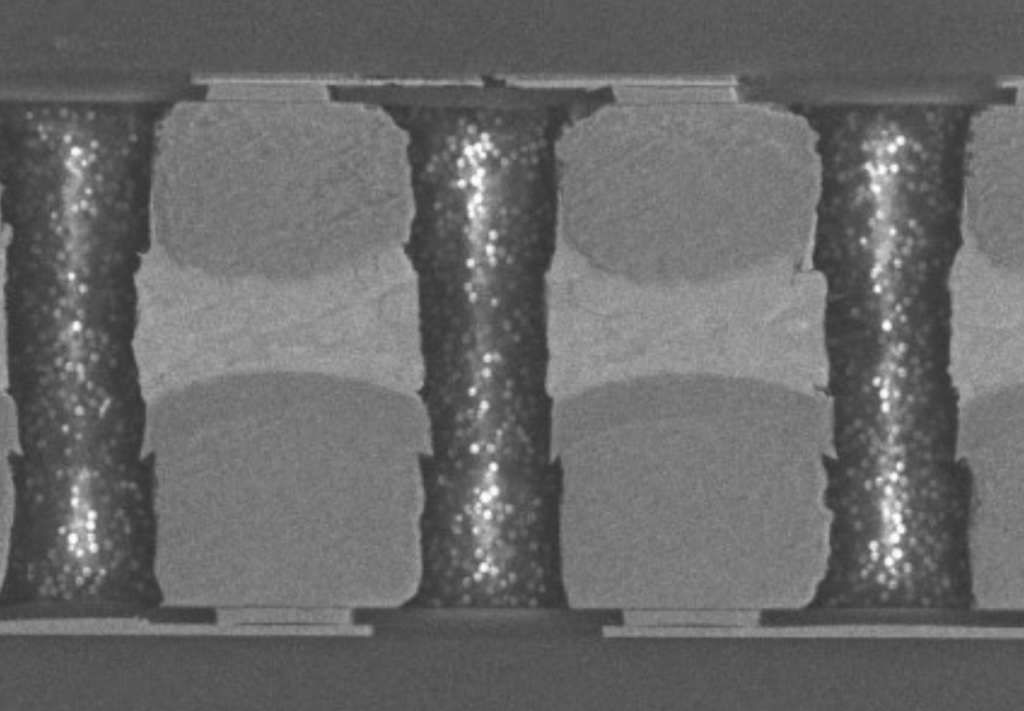
News
ASE’s VIPack™ Enables Innovational AI Devices Through Advanced Interconnect Technology for Chiplets
2024.03.20

Technology
AI-Driven Innovation for Manufacturing Automation
2023.12.01

News
ASE wins prestigious Red Dot Design Award
2023.11.10
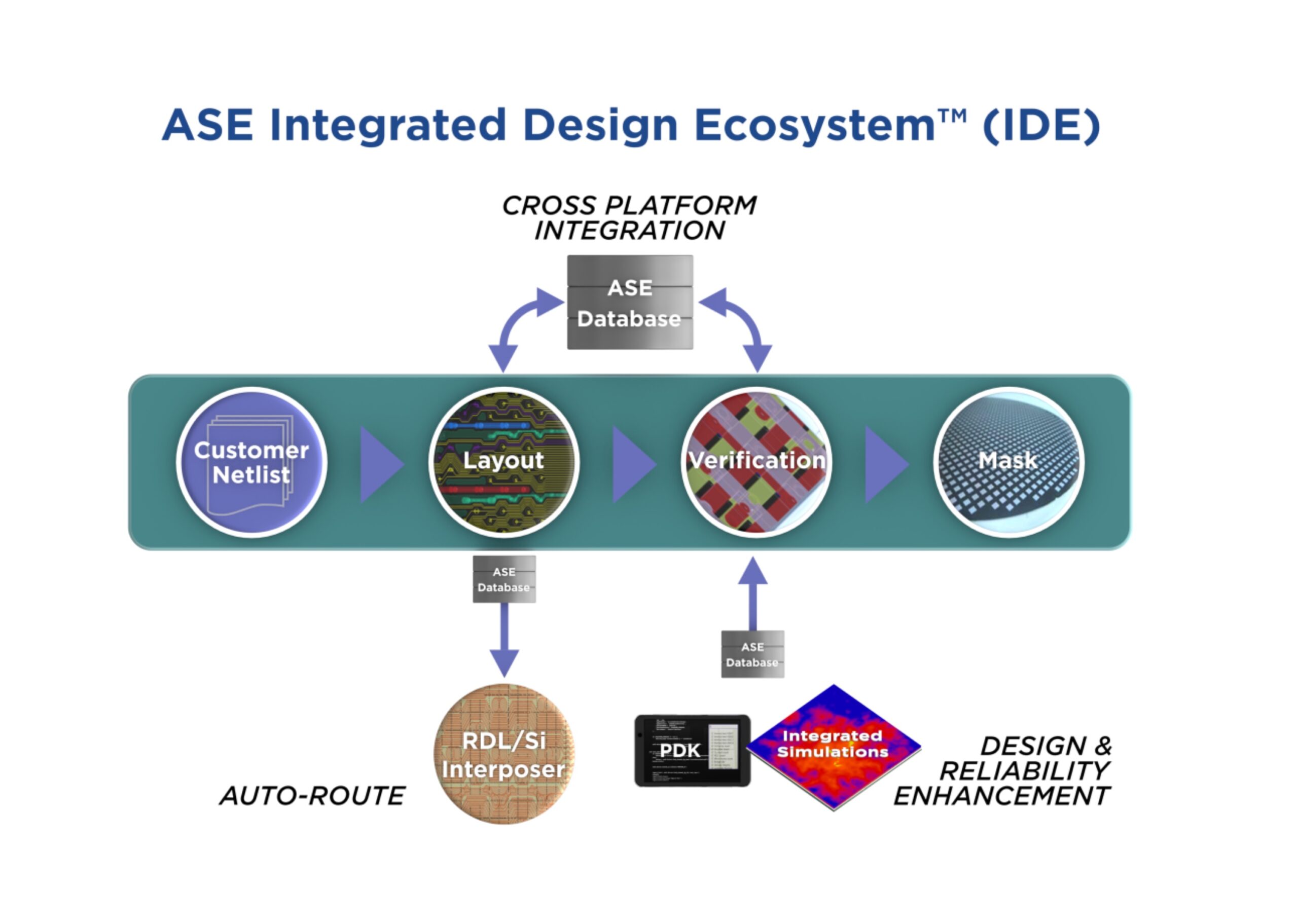
News
ASE launches its Integrated Design Ecosystem™ to enable silicon package design efficiencies that reduce cycle time by half
2023.10.03
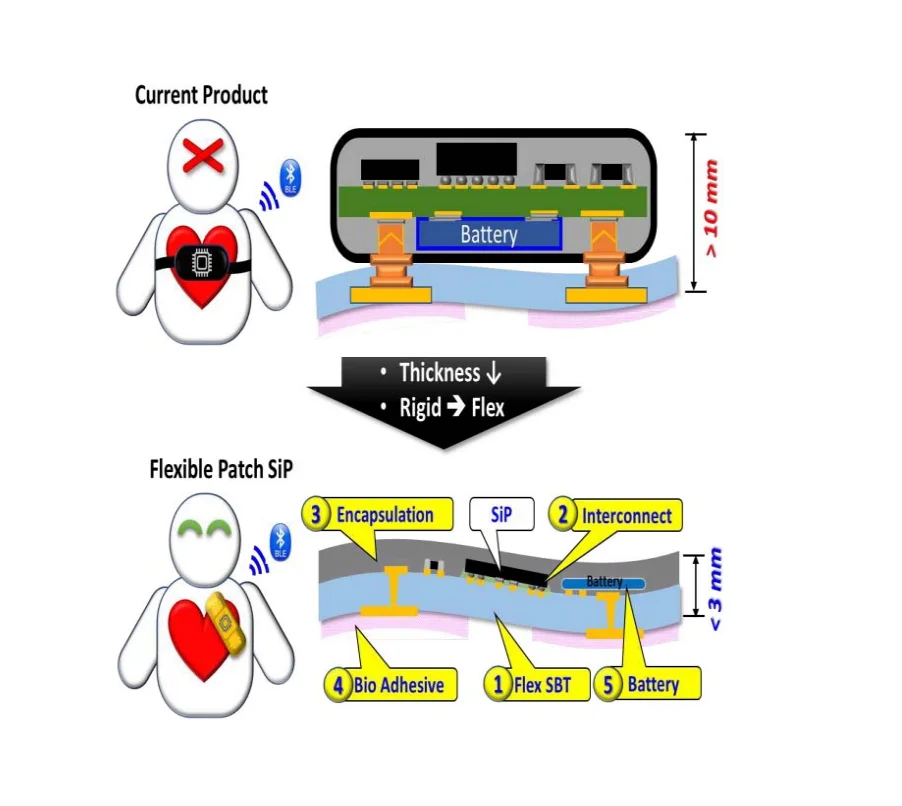
Technology Papers
Patch-type Flex SiP Platform for Heathcare Application
2023.08.03

News
ASE VIPack™ FOCoS-Bridge integrates multiple ASICs and silicon bridges to accelerate AI innovation
2023.05.31

News
ASE wins Device Technology of the Year award for VIPack™
2023.05.02
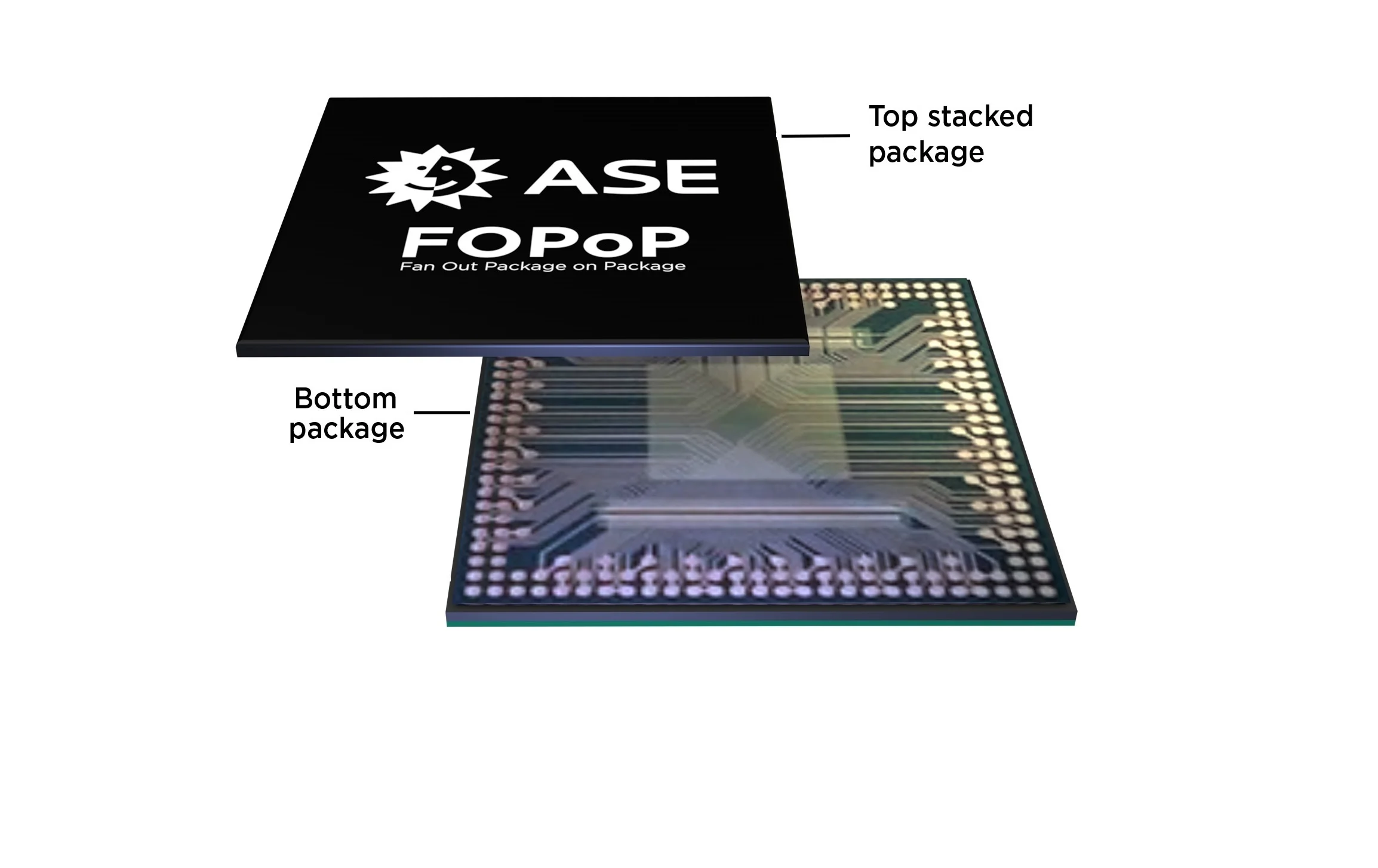
News
ASE drives latency and bandwidth innovation with VIPack™ Fanout Package-on-Package
2023.03.14

News
ASE’s Bumping Factory in Kaohsiung, Taiwan inducted into the World Economic Forum’s Global Lighthouse Network
2023.01.14