
部落格
聚焦小晶片(Chiplet)整合的2.5D/3D IC 先進封裝技術趨勢
呂妙玲

依據IDC 數據資料,全球資料數據總數在2025年將達到175ZB,巨量資料處理過程與傳輸即時化日趨重要,這使得高效能運算(HPC)以及矽光子(Silicon Photonics)成為半導體產業最重要的成長動能。隨著運算需求倍數增長,先進系統單晶片(SoC)效能提升在IC電晶體尺寸微縮上已經接近物理極限,因此將原有的大尺寸的SoC拆分成多顆體積更小、產量更高、不同功能的小晶片(Chiplet)設計日趨主流。
小晶片(Chiplet)整合技術中,細間距互連、大規模整合、電力傳輸以及散熱等都是未來主要發展方向。2.5D/3D IC先進封裝技術可以將小晶片(Chiplet)、記憶體與電源,在同一封裝中將進行做3D立體堆疊或使用矽中介層進行系統整合,縮短訊號傳輸距離,有效提升傳輸速率及能量效率。隨著矽光子(Silicon Photonics)技術發展,光的傳輸頻寬與效率也變得越來越高,把光學系統整合至單一封裝是未來重要的發展趨勢。
2.5D/3D IC封裝特性與異質整合
異質整合需要通過先進封裝提升系統性能,以2.5D/3D IC封裝為例,可提供用於記憶體與小晶片整合的高密度互連,包含提供次微米(Sub-micron)的線寬與線距、多達五層的互連金屬線路以及良品中介層(Known Good Interposer)。此外可通過DTC Interposer與IPD/Si Cap技術完成電源整合,通過高頻寬的封裝外互連(off-package interconnect)提供高性能的長距離資料傳輸。日月光目前與合作夥伴正在合作開發Optical Chiplet與Optical Interposer的技術,為進一步小型化提供可靠的解決方案。
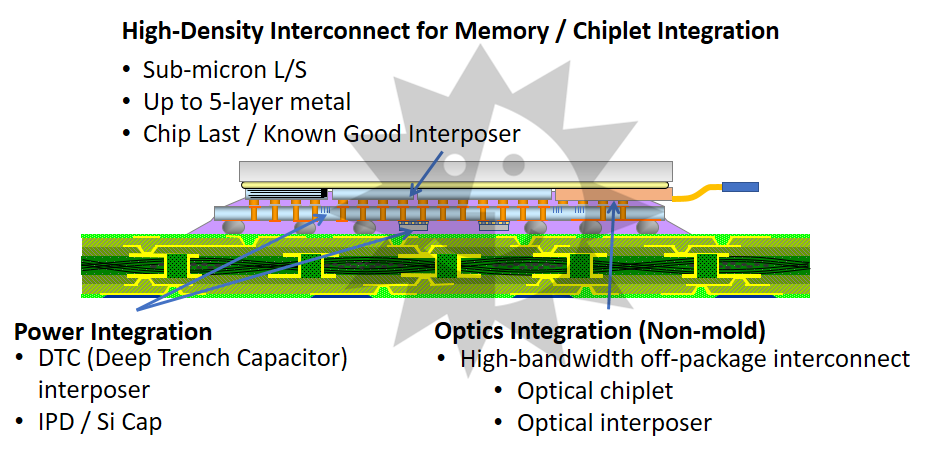
記憶體整合發展趨勢
隨著記憶體頻寬的需求越來越高,高頻寬記憶體的整合發展成為關鍵競爭力。記憶體整合未來主要發展趨勢為: 第三代高頻寬記憶體(HBM3)以及3D整合及堆疊(如SRAM堆疊及DRAM堆疊)。日月光率先在2015年量產HBM1整合的封裝,2017年HBM2也順利量產,在2021年量產HBM2E,目前正朝著3D整合方向發展。
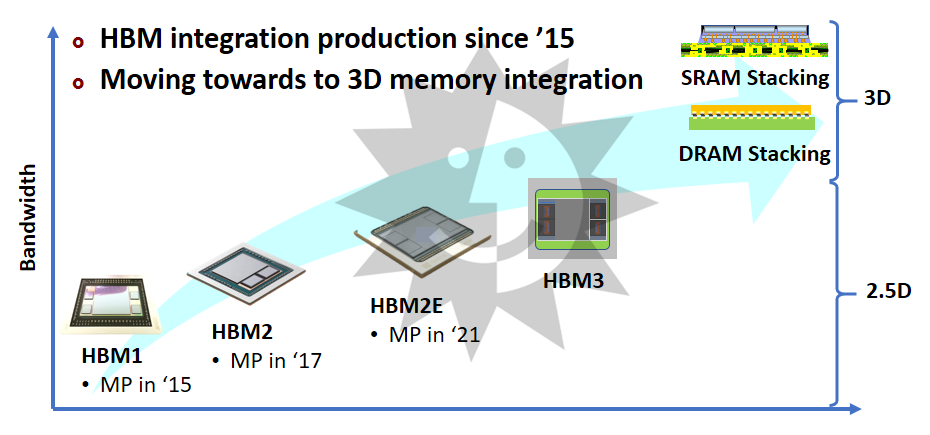
電源整合矽電容器(Si Cap)發展趨勢
隨著電源功率越來越高,電容密度的要求也同步提高,因此電容整合的重要性尤為突出。日月光正在與合作夥伴共同開發不同的矽電容器(Si Cap)技術,例如溝槽電容器(Trench Capacitor)以及電容密度更高的堆疊電容器(Stacked Capacitor),以滿足越來越高的電容密度需求。
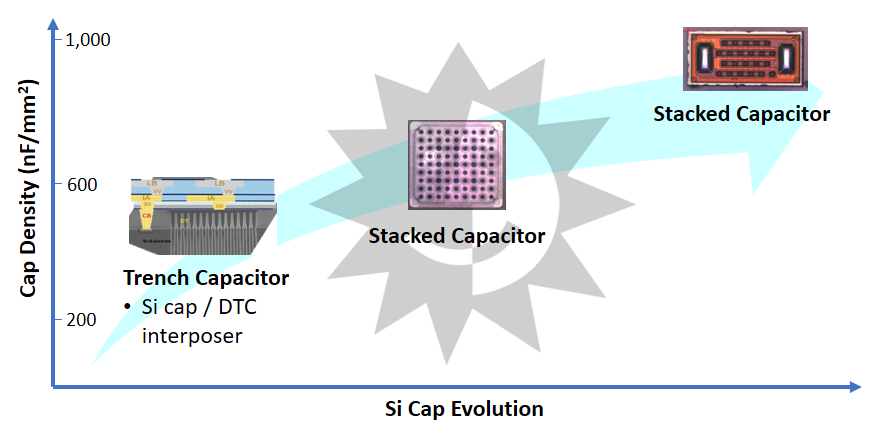
光學整合發展趨勢
頻寬與能量效率問題是未來電的長距離傳輸主要瓶頸,因此光學整合成為重點發展趨勢之一。目前日月光與合作夥伴開發兩種不同的光整合技術,第一個是光學小晶片(Optical Chiplet)技術,應用2.5D 矽中介層(Silicon Interposer)整合光學小晶片以及SoC技術,以滿足最高的能量效率與最高的頻寬,如應用於高速運算光學I/O的要求。另一個發展趨勢是基於3D整合的光學中介層(Optical Interposer)技術,即電子IC在上面,光子IC在下面,這種整合方式可提供更高的頻寬級能量效率的需求,可應用於網路交換機。

日月光持續開發可優化時脈速度、頻寬和電力傳輸的先進封裝技術,如Fan-Out Package on Package (FOPoP)、Fan-Out Chip on Substrate (FOCoS)、FOCoS-Bridge 、 Fan-Out System in Package (FOSiP) 、2.5D 與 3D IC 封裝、Co-Packaged Optics以及混合鍵合(Hybrid Bonding)技術,與產業鏈合作夥伴們在VIPack™平台共同研發合作,縮短共同設計時間、產品開發和上市時程,以滿足高效能運算(HPC)以及矽光子(Silicon Photonics)整合發展需求。