
新聞中心
日月光VIPack™ 系列 – 扇出型堆疊封裝(FOPoP)實現低延遲高頻寬優勢的解決方案
日月光半導體(日月光投資控股股份有限公司成員 – 台灣證交所代碼:3711,紐約證交所代碼:ASX)今日宣佈最先進的扇出型堆疊封裝(Fan-Out-Package-on-Package,FOPoP)滿足移動裝置和網路通訊市場可以降低延遲性和提高頻寬優勢的解決方案。日月光VIPack™平台中的FOPoP將電氣路徑減少3倍,頻寬密度提高8倍,使引擎頻寬擴展每單位達到6.4 Tbps。FOPoP是解決複雜集成需求的重要封裝技術,有助於提供應用處理器、封裝內天線設備和矽光子(SiPh)應用產品的下一代解決方案。
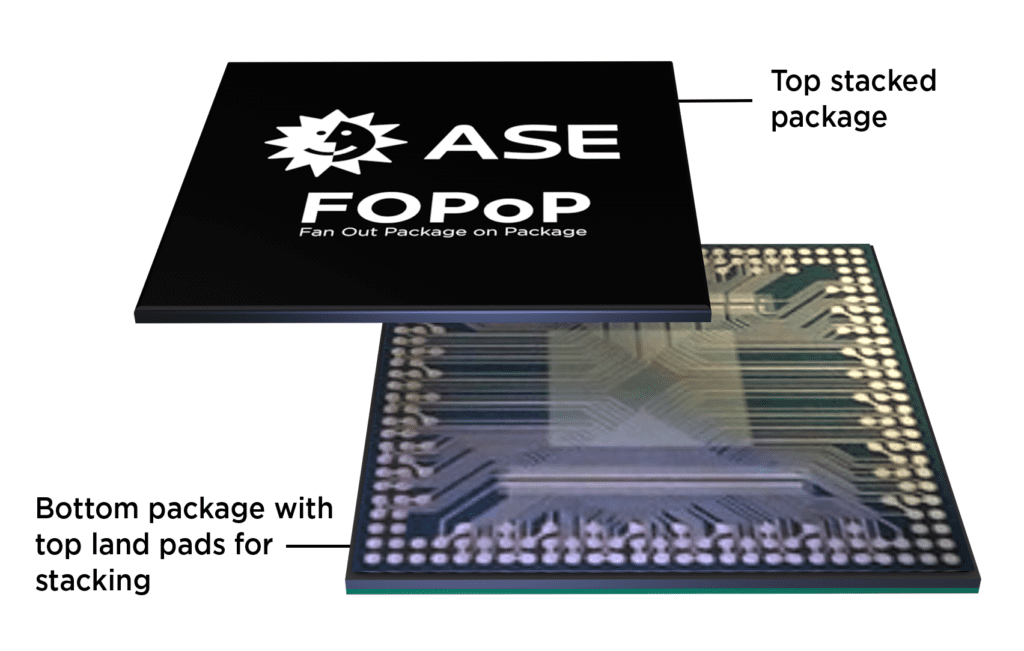
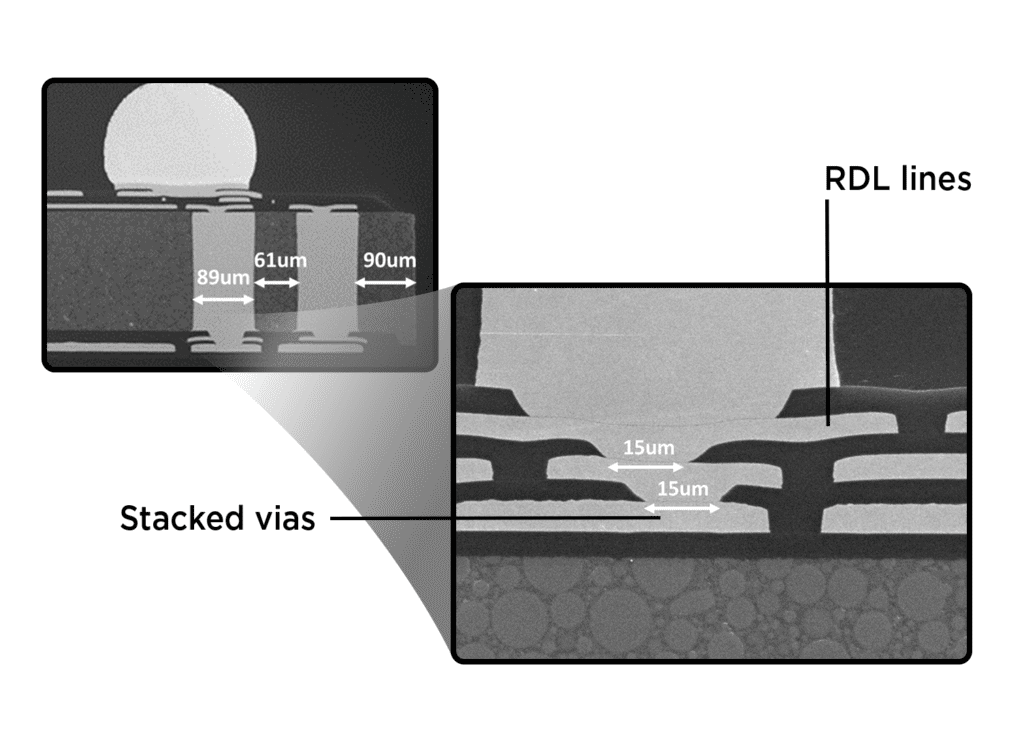
先進封裝的創新優勢為競爭日益激烈的市場帶來前所未有的機遇。尤其是外形尺寸的改變和電性優勢為客戶提供優質方案,支援客戶實現產品更高效的萬物互聯。隨著5G成為主流,速度和效率大大提高人類生活品質,因此對依賴超低延遲的複雜應用需求越來越大。日月光FOPoP封裝結構是最先進的垂直整合的集成技術,具備新型互連能力、增強驅動阻抗、堆疊通孔和啟用垂直耦合等特性,延續未來長期技術藍圖的需求。
在移動裝置應用中,FOPoP封裝擁有更薄的封裝尺寸,同時消除基板寄生電感,其高密度、無基板的特性實現更高的封裝性能。FOPoP結構通過更精細的RDL線距,與基板相比,能提供更高的互連密度和集成度,更短距的互連長度,實現更好的電性性能以及更小、更輕薄的尺寸。FOPoP封裝平台透過RDL多重佈線層連結兩側裸晶來提高集成度和功能性,增強複雜且高性能需求。此外,也運用接腳側 (land side)電容和近晶片深溝槽電容,滿足先進節點的電源完整性要求。
在網路通訊應用中,FOPoP有助於實現下一代可插拔光收發器頻寬從400G提高到800G,同時也利用共同封裝光學元件(CPO)提供高度可行的集成解決方案。3D堆疊在光子積體電路(PIC)和控制器之間提供更短的互連,以達到更快的速度。FOPoP 3D堆疊是提升每尺寸更高頻寬的解決方案,同時可以使小尺寸矽光子引擎(SiPh engine)和ASIC整合封裝更容易,將是CPO關鍵技術。
FOPoP在移動裝置市場的主要優勢:
- 超低側高的特質比基板型封裝堆疊結構(Package-on-Package) 高度降低40%
- 優化電性效率提供先進矽節點電源優勢
- 先進的材料能夠在高溫下獲得良好的翹曲效果,呈現較好的表面黏裝良率
- 與傳統基板基電介質相比,使用扇出型PI(Fan Out Polyimide)可在更大的高頻範圍內保持穩定的介電常數(Dk)
- 新型製程和結構擴展產業藍圖,實現未來小晶片Chiplet的更多樣異質和同質集成
FOPoP在網路市場的主要優勢:
- 減少電氣路徑3倍,提高頻寬密度8倍,引擎頻寬擴展達到每單位4 Tbps
- 能效改善從25pJ/bit提高到5pJ/bit
- 10GHz以上優異損耗控制
- 提供雷射器、光學器件和光纖站陣列最先進的PIC、控制器晶片和特別預對準結構整合
- 通過使用被動對準,提供亞微米精度,提高光學耦合性能和封裝效率
日月光研發副總洪志斌博士表示:「FOPoP在移動裝置和網路通訊領域中克服幾何架構的複雜性、實現電性效率且改變遊戲規則,證明其具有極大的價值。憑藉日月光豐富的經驗和充足的技術基礎能量,加上對研發的堅定承諾,日月光持續創造行業領先的封裝解決方案,以滿足客戶需求。」
日月光銷售與行銷資深副總Yin Chang表示:「透過VIPack™垂直互連整合技術創新力的戰略焦點,持續加快先進封裝平台的發展步伐,確保我們的解決方案在市場上具有令人信服的性能。FOPoP是封裝獨創性的最佳範例,協助我們的客戶保持領先,並將新一代產品迅速推向市場。」
日月光VIPack™ – 扇出型堆疊封裝(FOPoP)解決方案是根據產業藍圖可擴展的創新平台。
更多詳細資訊
- FOPoP資訊,請瀏覽:https://ase.aseglobal.com/en/technology/fopop
- VIPack™資訊, 請瀏覽:ase.aseglobal.com/en/VIPack
- 關注日月光LinkedIn,獲取最新資訊@aseglobal
- 關注日月光Twitter @aseglobal
關於日月光半導體
日月光半導體為全球半導體封裝測試製造服務領導公司,提供完整且廣泛的封裝測試技術服務客戶,更以創新的先進封裝與系統級封裝解決方案,滿足現今市場上日益成長的5G、汽車、高效能運算等等的應用需求。我們為推動改善生活型態與效率,持續發展先進技術服務,查詢更多系統級封裝、扇出型封裝、感測器封裝、覆晶封裝以及2.5D、3D和矽穿孔(TSV)技術的相關訊息,請至ASE Website 或 關注日月光 LinkedIn 與 X 專頁: @aseglobal。