
晶圓級封裝
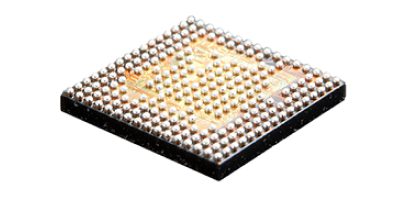
ASE is with solid experience and superior capability to provide a broad range of Wafer Level Package (WLP) solutions from chip scale packages to SiP to homogeneous and heterogeneous chip integration. ASE is able to provide thinnest profile, lower-power consumption and high-performance solutions.
ASE WLP solution meets current needs in various applications from client device to infrastructure and high-performance cloud computing, even emerging appliance such as VR/AR, autonomous driving, smart Robots.
ASE Wafer Level Packaging Offerings

To service the fast-growing market within PDA and cell phone, this smaller chip size is essential. In 2001, ASE licensed Ultra CSP® from Kulicke & Soffa's Flip Chip Division. ASE also provided several enhanced structures called "aCSP™" by polyimide, PBO, or thicker Cu RDL to meet various customer demands. aCSP™ is a wafer level CSP package that can be Direct Chip Attached to the PCB board without any interposer. Also, aCSP™ provides the shortest electrical path from Al pad to PCB board to enhance the electrical performance. It has been broadly used in portable devices in passives, analog and logic applications, and is extending to RF applications.
Applications
- Bluetooth/Wi-Fi
- Analog Devices
- Power and Voltage Regulator
- Cell Phones and System Boards
- GPS
- Microcontrollers/Integrated Passives
- Power Amplifier
- FM Radio
- EEPROM
- RF Devices
Features
- Real chip size (smallest, thinnest and lightest)
- High-density interconnection
- High-speed data processing
- Batch process-assembly processed in wafer form
- Wire-bond type die can be directly switched to Acsp
Product Offerings
- aCSP: Through ball drop process
- WLCSP: Through ball printing/plating process
Advanced Technology under Development
- Wafer technology: Qualification for 22 and 16nm wafer
- Ball pitch: 300um
- Ball size: 150um ball drop
- Grinding: Die thickness 150um
- Plated RDL line/width: 10/10um; 8/8um
- Plated RDL thickness: >=7um
- Sawing: Laser sawing