
部落格
2022 / 04 / 22
系統級封裝SiP協助實現多樣化應用
呂妙玲
半導體微型化和高度整合的趨勢,使系統級封裝 (SiP)的發展越來越被業界重視。提供更高性能、具成本效益以及縮短上市時程的特性,SiP協助實現電子產品更多功能性與新應用發展。
健康醫療應用
日月光研發中心副總經理洪志斌博士以CGM以及IVD為例舉例說明系統級封裝SiP技術在健康醫療上的解決方案。
連續式血糖監測系統CGM
SiP技術可將不同的微控制器(MCU)、特定應用積體電路(ASIC)、天線,以及各種不同功能的感測器集成在單一封裝結構中,使系統的總尺寸減小60%但性能大為提高。
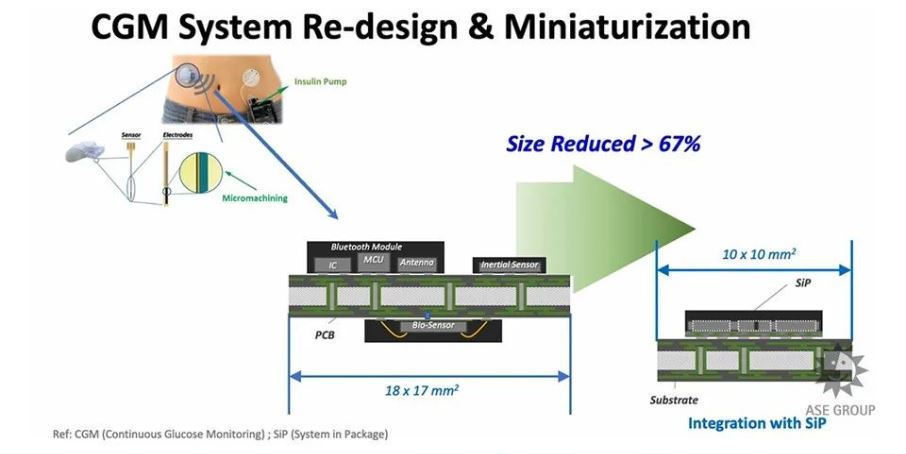
體外診斷模組IVD
透過選擇性塑封技術,SiP技術可在基板結構上整合生物晶片的感測區域以及微流體結構,成為多用途體外診斷模組。
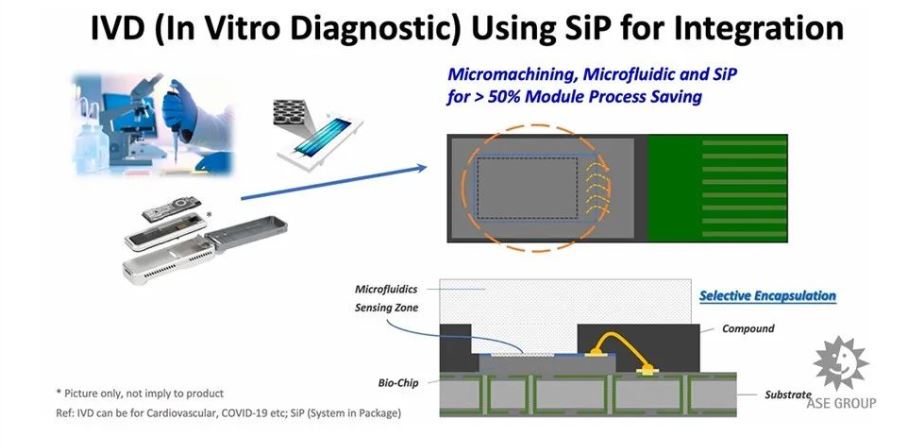
感測器應用
洪博士進一步說明晶圓級SiP技術在感測器封裝上的應用。晶圓級SiP技術可將常見的方形扁平無外引腳封裝(QFN),轉換成尺寸更小、有矽穿孔(TSV)的晶片尺寸級封裝(CSP) ,不僅減少30%的XY面積尺寸,同時減少80%的電阻,從而增強封裝結構的電性效能。
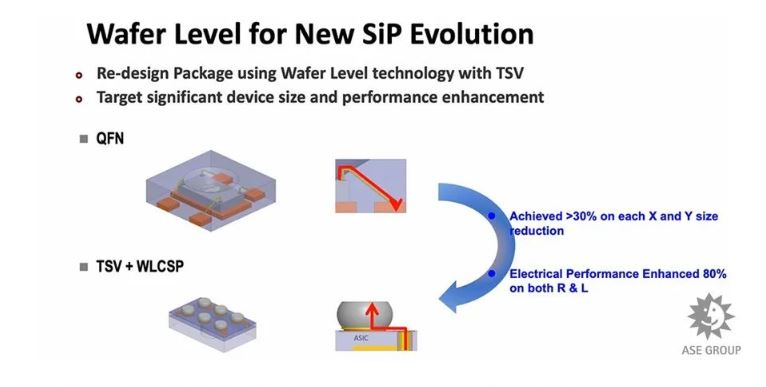
感測器中樞(Sensor Hub)
結合矽穿孔(TSV)以及晶片到晶圓(Chip to Wafer, C2W)接合技術,可以協助實現感測整合器中樞(Sensor Hub)整合。ASIC和感測器元件既可以並排放置,也可以把有TSV結構的晶片放在另一個沒有TSV結構的晶片上面。
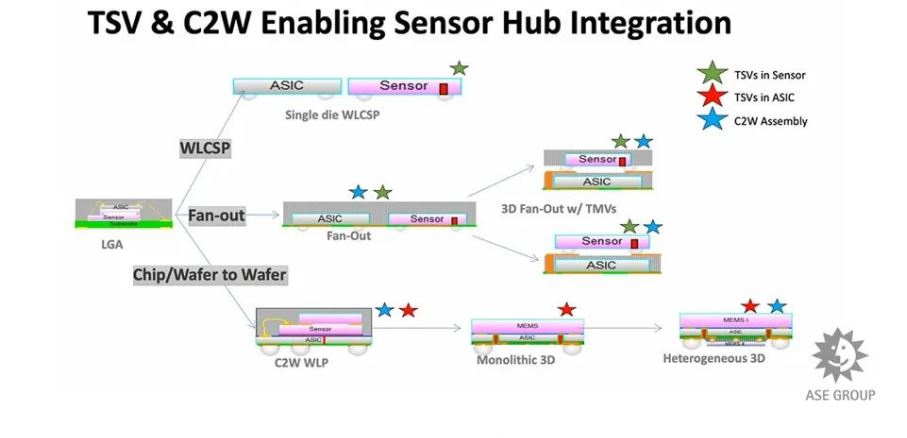
晶圓級SiP技術可以應用在不同的感測器封裝,例如3D的慣性感測器,還有氣體感測器、壓力感測器、濕度感測器和溫度感測器等,從以下圖表中可以看到,封裝尺寸可以分別縮小25%至77%。

從封裝設計、元件模擬功能到量測、驗證、量產製造到產品測試,日月光持續提供領先業界的系統級封裝整合解決方案,協助客戶加快產品開發速度。

