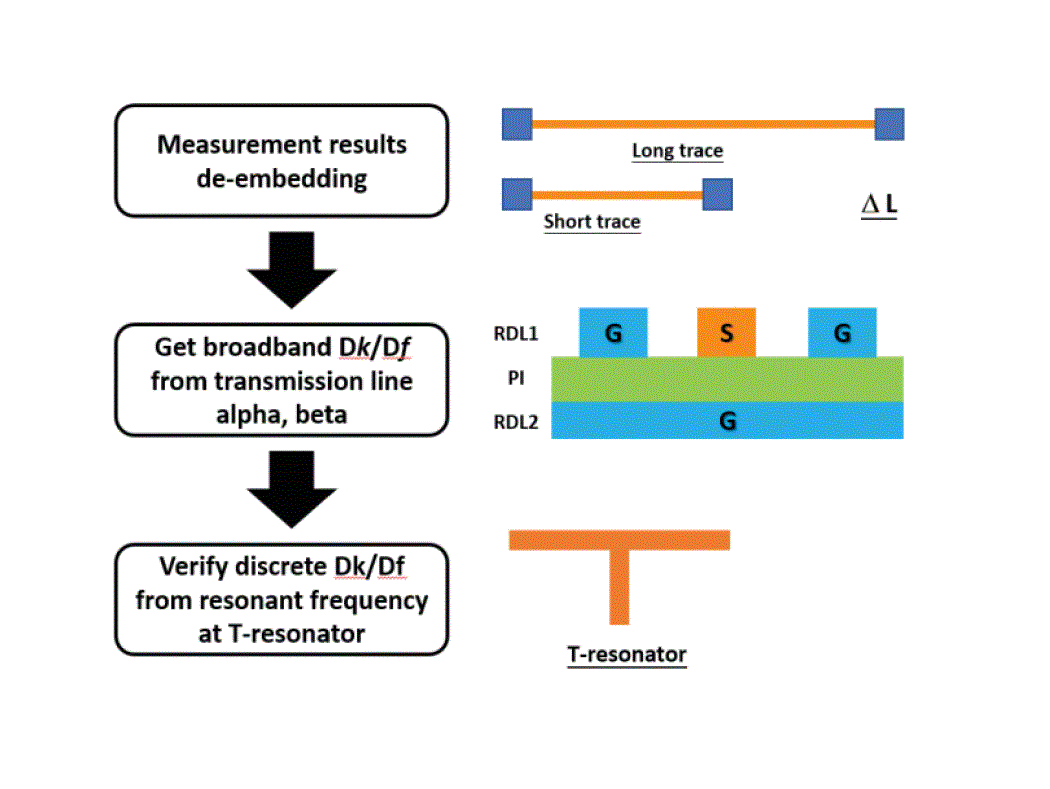
post
Dk/Df Extraction and Moisture Effect on mmWave Fan-out Package Design
In order to ensure the performance of high-frequency fan-out package design, especially at mmWave application, the influence of substrate dielectric characteristic is very serious. Polyimide (PI) material is common material used in Fan-out package. The moisture effect of PI is very obvious in stress and electrical performance. Sso this paper… Read More