
部落格
可自由组合的「SiP自助餐」
呂妙玲
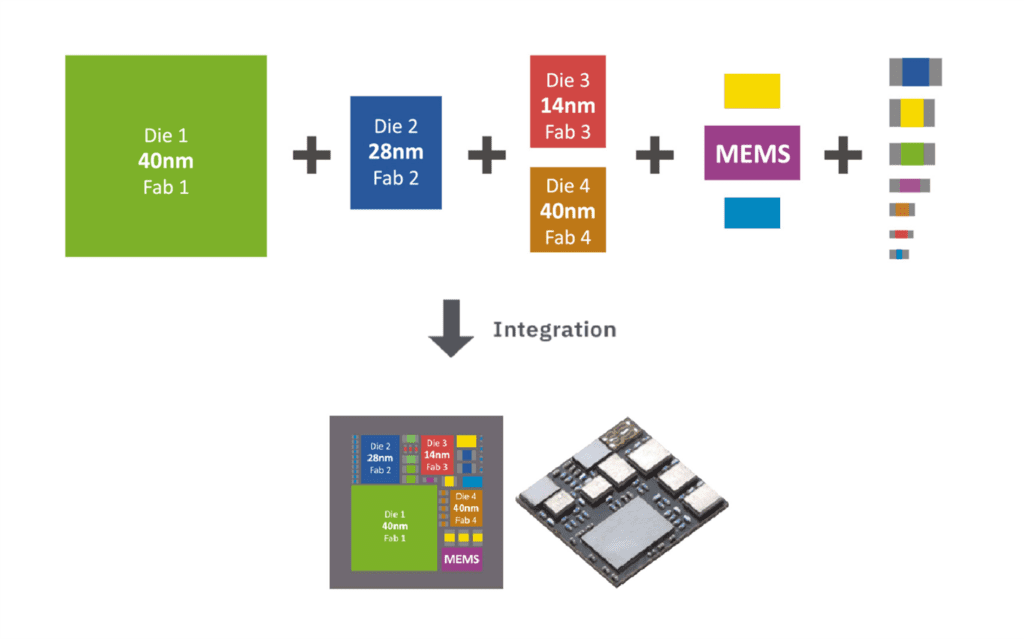
隨著手機功能愈來愈多,需要的半導體元件也隨之增加,並且5G 時代的到來,使手機需要整合的通訊元件再次提升,由於手機硬體空間有限,因此置入的半導體元件日趨多功能化與微小化,元件間的系統化整合也被視為未來的重點發展技術。相較於系統單晶片(System on a Chip, SoC)的開發成本/時間快速攀升以及異質整合困難度快速提高,系統級封裝(System in a Package, SiP)可將原本分別製造組裝的半導體元件,整合為單一封裝構造,因此可以相對較低的成本,提供更強大的功能。
SoC猶如一個「固定套餐」,而SiP就是「自助餐」,可根據功能和需求自由組合,提供彈性化設計。以手機為例,可進行系統整合的功能模組包括感測器(Sensors)、互聯(Connectivity)、射頻前端模組(RF FEM)以及基帶(Baseband)。將原本獨立製造的晶片/零組件,根據不同的功能整合成模組後,從個別功能整合成子系統,再安裝整合到手機系統PCB上,藉此可將整體尺寸縮小57%,預留更大的空間放置電池,提供更大的電力儲存,延長產品的使用時間,使手機的厚度變薄,但功能更多、速度更快。
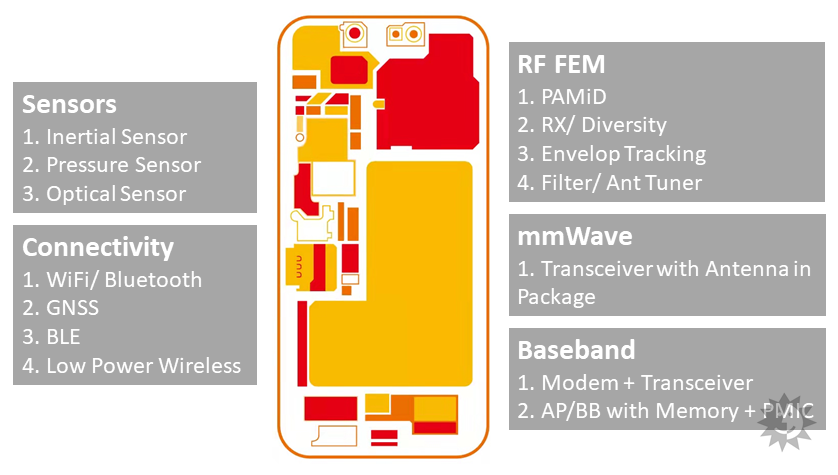
系統級封裝SiP技術趨勢
高性能、高整合及微型化需求推動系統級封裝SiP技術持續升級,從最初最簡單的Open Top、共形屏蔽(Conformal Shielding),逐步發展分區屏蔽(Compartment Shielding)、雙面壓模(Double Side Molding, DSM)、天線整合封裝等技術,未來將朝著3D系統級封裝及扇出型(Fan Out) SiP方向發展,提供更高的整合能力與更強的性能。此外,可實現線路層用晶圓級(wafer level)製程的系統級封裝SiP及更高級別整合的替代解決方案,提供最輕薄短小的封裝。
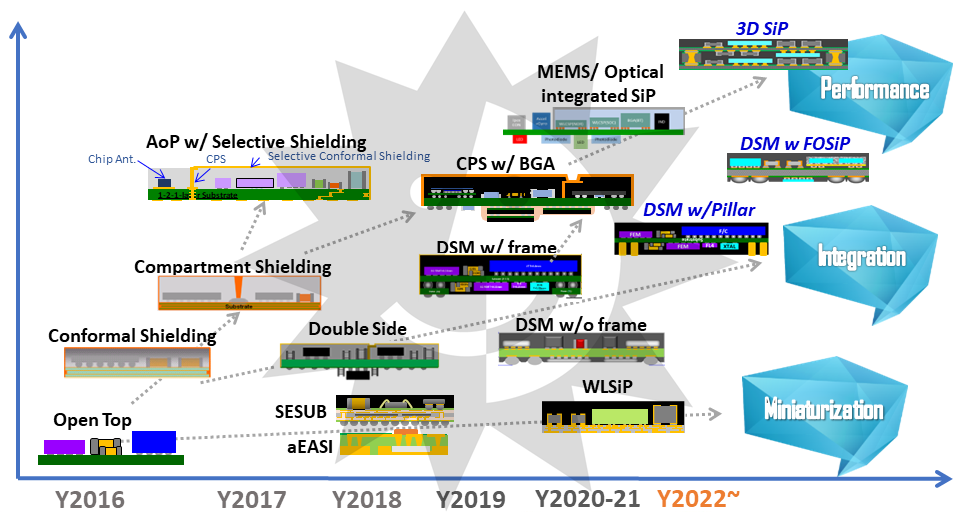
MEMS與感測器封裝應用
MEMS與感測器主要有Open Top和Seal這兩種封裝方式。Open Top所用感測器功能需要與外界有所溝通,通常包含微光學(Optical MEMS),環境感測器(Environmental Sensor)以及麥克風所用到的聲學感測器(Acoustic Sensors)。另一種封裝方式是Seal,以封膠(molding)的方式保護線路和互聯模組,主要運用在慣性感測器(Inertial Sensor),包含加速度計、陀螺儀、磁力計、IMU、羅盤、感測器中樞(MCU)等,以及射頻元件中的天線調諧器、射頻濾波器及振盪器等。

系統級封裝SiP關鍵技術
系統級封裝SiP的關鍵技術涵蓋從Die Interconnection的打線(Wire Bond)及覆晶(Flip Chip),到利用008004被動元件,縮小零件間距至40μm的高密度表面組裝技術(SMT)。此外,系統級封裝SiP可運用分區屏蔽(Compartment Shielding)及選擇性封膠(Selective Molding)實現更好的電磁屏蔽功能,封裝成型可依據客戶的設計做不同形狀的模組,可以是任意形狀,甚至3D立體結構,適用於5G mmWave模組與真無線藍牙耳機(TWS)等領域。
產品可追溯性
日月光有一套完整的產品可追溯系統,可追溯晶片及模組在整個生產過程中的生產履歷,比如可以輕鬆查晶圓的出處,基板的ID,甚至基板的位置,以及所有材料ID、機台形式、機台號碼以及相關的作業人員,只要掃Unit ID即可提供客戶完整的資料。
日月光提供全面且多元的先進封裝及系統級封裝SiP製造服務,從更優化的晶片設計到電性、熱與機械性質的模擬、失敗分析,以及製造的整合與彈性化的營運,是產品開發與量產的最佳合作夥伴。