
部落格
全面性系統級封裝SiP推動新系統整合
呂妙玲

日月光研發中心副總經理洪志斌博士在電子封裝國際論壇上全面解析系統級封裝SiP如何推動新系統整合,特別是嵌入式封裝(Embedded)、覆晶封裝(Flip Chip)以及扇出型封裝(Fan Out)如何以更高密度、更小尺寸和更短週期設計流程來實現在AIoT、5G、汽車電子、邊緣運算和大資料的應用。
洪博士表示未來10年將呈現新的3C趨勢,即收集(Collect)、互連(Connect)及運算(Compute),利用感測器、雷達等裝置採集資訊並通過5G、WiFi、藍牙等方式在電腦進行AI運算和智慧處理。人類對電子產品的功能需求不斷升級,推動晶片和封裝技術朝功能最優化但尺寸微型化方向發展,嵌入式系統整合封裝(a-EASI)和基板型嵌入式封裝(SESUB)因其技術特性和解決方案將廣泛應用。
嵌入式系統整合封裝(a-EASI)

嵌入式系統整合封裝(a-EASI)是結合導線架(Leadframe)和基板技術的封裝技術,適用于所有的整合電源設備。利用引線框架的底座結構使其具備強大的電流處理能力及散熱能力,是一種低損耗、高熱性能的解決方案,不僅設計靈活,可使晶片尺寸縮小50%,功耗降低80%以上,還能保持良好的穩定性和可靠性。特別是在汽車應用領域,a-EASI技術可以為ATV Grade 0級別車用處理多達2000多個溫度迴圈檢測, 提高汽車的高可靠性性能。
基板型嵌入式封裝(SESUB)

基板型嵌入式封裝(SESUB)是將積體電路嵌入層壓基板的技術,嵌入的基板可以安裝各種電子元件,形成高度整合的多功能封裝。SESUB支援功能性電路的微模組化,例如智慧手機的高性能PMUs以及藍牙模組等,同時通過減小模組的嵌入高度和底面積實現縮小模組尺寸的功能,可使電源管理單元模組縮小60%,音訊模組縮小32%,藍牙低能量模組縮小65%及DC/DC變頻器模組縮小36%等。
日月光的嵌入式技術被認為是實現更高級別整合的替代解決方案,提供SMT整合和靈活的佈線解決方案以減小PCB尺寸,同時採用金屬引線框架進行模具佈局,具有高散熱性和電磁干擾效益。
洪博士還舉例說明MEMS基於引線框架、BGA封裝、覆晶封裝(Flip Chip)、晶圓級封裝(Wafer Level CSP)、扇出型封裝(Fan Out)以及矽通孔(TSV)的系統級封裝SiP技術可根據不同目的做相應的調整。例如可以用導線架和BGA封裝技術實現經濟高效的封裝解決方案,而如果要進一步加強壓力控制,可以對結構進行重新計算,採用不同的基板以及打線(Wire Bond)技術予以實現。
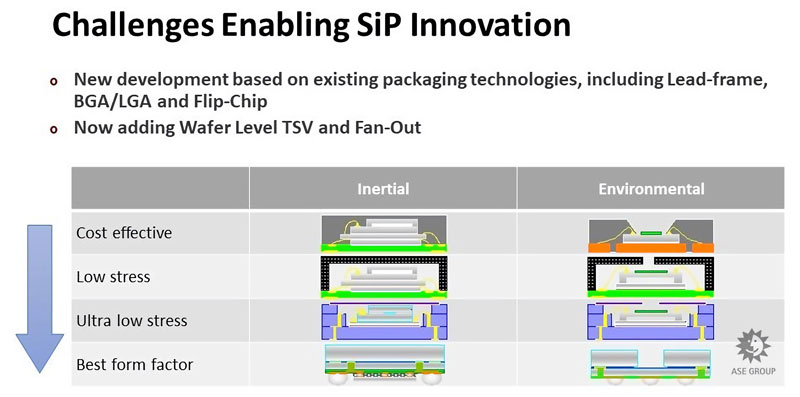
未來a-EASI 、SESUB、導線架、BGA封裝、覆晶封裝(Flip Chip)以及晶圓級TSV技術等都可以滿足包括5G、AI、智慧汽車以及邊緣計算等所有應用的需求,可根據要求整合多項封裝技術,從而成功實現系統級封裝SiP異質整合能力。日月光將持續強化在先進封裝、測試技術及基板設計等方面的競爭力,為客戶提供嵌入式晶片封裝的全方位解決方案。

