
新聞中心
日月光 VIPack™系列FOCoS-Bridge整合多顆ASIC封裝解決方案加速人工智能創新
日月光半導體(日月光投資控股股份有限公司成員 – 台灣證交所代碼:3711,紐約證交所代碼:ASX)今日宣佈Fan-Out-Chip-on-Substrate-Bridge(FOCoS-Bridge)實現最新突破的技術,在70mm x 78mm尺寸的大型高效能封裝體中透過8個橋接連接(Bridge) 整合2顆ASIC和8個高頻寬記憶體(HBM)元件。此大型高效能封裝體包含兩顆相同尺寸 47mm x 31mm的FOCoS-Bridge的扇出型封裝結構。FOCoS-Bridge是日月光VIPack™平台六大核心封裝技術支柱之一,旨在實現高度可擴展性,無縫集成到複雜的晶片架構中,同時提供高密度晶片對晶片連接(D2D)、高I/O數量和高速信號傳輸,以滿足不斷發展的人工智能(AI)和高效能運算(HPC)需求。

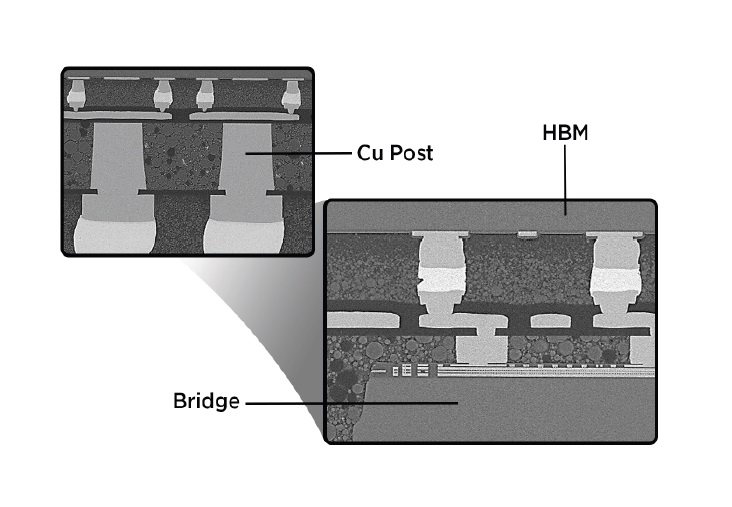
FOCoS-Bridge技術解決日益增長的人工智能(AI)和高效能計算(HPC)應用中對更高頻寬和更快數據傳輸速率的需求。充分利用高度集成的扇出型封裝結構優勢,克服傳統電性互連的限制,實現處理器、加速器和記憶體模組之間的高速度、低延遲和高能效的數據傳輸。兩個FOCoS-Bridge結構均包含1顆主晶片, 4顆HBM和4顆橋接的Bridges,有效地將9個元件集成在47mm x 31mm尺寸的扇出型封裝體中,幾乎兩倍的光罩尺寸(Reticle Size) 。FOCoS-Bridge在扇出型封裝結構的基礎中允許嵌入被動和主動元件的技術的選項,可以選擇提供用於優化功率傳輸的去耦電容或用於連接功能性(如記憶體、I/O等)的晶片元件。
日月光FOCoS-Bridge特性是次微米L/S的超高密度晶片對晶片(D2D)互連功能,可實現小晶片Chiplet集成的高頻寬與低延遲。使用橋接晶片使主晶片邊緣的線性密度(線/毫米/層)比傳統的覆晶封裝(Flip Chip) 密度更超過百倍。此外,FOCoS-Bridge支持串列和平行介面以及相關的標準,如XSR、BOW、OpenHBI、AIB和UCIe,廣泛實現晶片對晶片(D2D)的互連。
人工智能(AI) 涵蓋範圍幾乎遍及所有行業和科學領域, 已經從自動汽車駕駛滲透到醫療診斷。人工智能(AI)和高效能運算(HPC)的相互融合對半導體行業產生極大影響,推動了對創新封裝解決方案的需求。高效能運算(HPC)和伺服器SoC需求達到光罩尺寸(Reticle Size) 的極限,同時需要高頻寬記憶體集成,就必需透過FOCoS-Bridge技術來實現。此外,FOCoS-Bridge技術有助於更高效地利用運算資源,加速數據密集型運算,並推動人工智能演算法、深度學習、科學模擬及其他運算密集型工具。
「FOCoS-Bridge技術的突破推動了人工智能和高效能運算的發展,解決數據傳輸、性能和功耗相關的關鍵挑戰。」日月光研發副總洪志斌博士說道,「隨著人工智能(AI)和高效能計算(HPC)改善我們的生活、工作、娛樂和溝通方式,我們很高興日月光FOCoS-Bridge和創新的先進封裝技術扮演重要的推動角色。」
「日月光極力於創造能實現高頻寬記憶體(HBM)和高密度小晶片Chiplet集成的整合技術,以滿足客戶將尖端應用帶入市場的需求。」 日月光銷售與行銷資深副總Yin Chang強調,「我們不斷創新帶來變革性解決方案,FOCoS-Bridge是最佳案例,不僅強化VIPack™產品組合,同時也為人工智能領域的創新和發展開闢新的可能性,使我們的客戶能夠克服嚴峻的技術挑戰,實現新的效能、可擴展性和能源效率。」
日月光FOCoS-Bridge技術是VIPack™平台之一,VIPack™是根據產業藍圖強化協同合作的可擴展創新平台。
更多詳細資訊
- FOCoS-Bridge資訊,請瀏覽:ase.aseglobal.com/focos-bridge/
- VIPack™資訊,請瀏覽:ase.aseglobal.com/ch/vipack
- 關注日月光LinkedIn,獲取最新資訊@aseglobal
- 關注日月光Twitter @aseglobal
關於日月光半導體
日月光半導體是日月光投資控股股份有限公司(台灣證交所代碼:3711,紐約證交所代碼:ASX)成員,全球半導體封裝測試製造服務領導公司。我們提供完整且廣泛的封測技術服務客戶,更以創新的 VIPack™、先進封裝和系統級封裝解決方案,滿足現今市場上日益成長的人工智慧、汽車、5G、高效能運算等應用需求。為推動改善生活型態與效率,我們持續發展先進技術服務,查詢更多系統級封裝、扇出型封裝、MEMS 和感測器封裝、覆晶封裝以及2.5D、3D和矽穿孔(TSV)技術的相關訊息,要了解我們在SiP、扇出、MEMS 和感測器、倒裝晶片以及2.5D、3D 和TSV 技術的進展,請造訪:ASE Website ,或在LinkedIn 上關注我們X:@aseglobal。