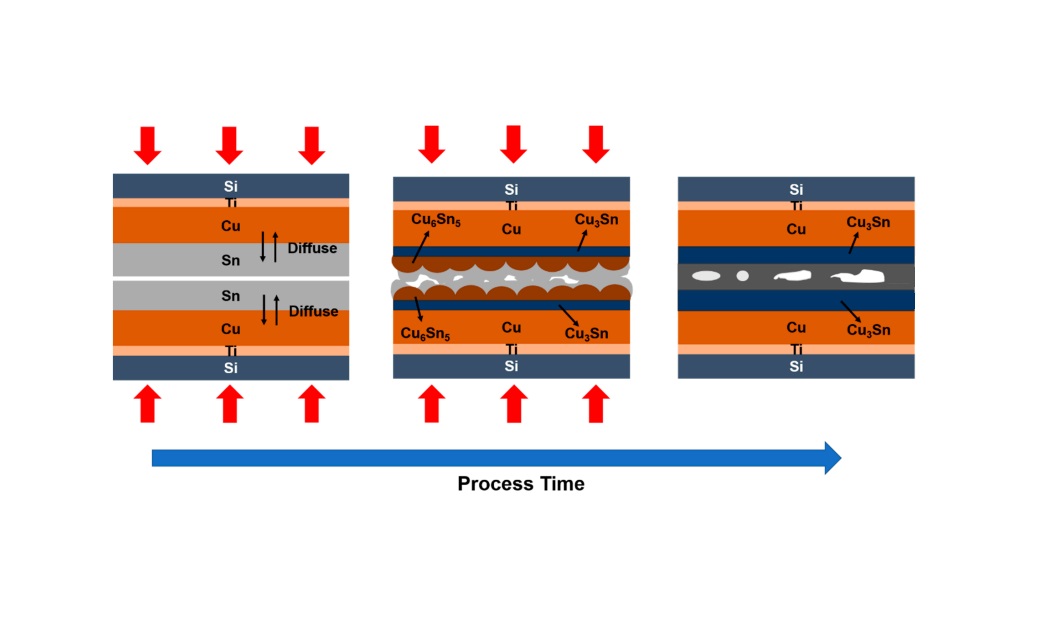
post
Investigation of Low-Pressure Sn-Passivated Cu-to-Cu Direct Bonding in 3D-Integration
Cu-to-Cu direct bonding plays an important role in three-dimensional integrated circuits (3D IC). However, the bonding process always requires high temperature, high pressure, and a high degree of consistency in height. In this study, Sn is passivated over electroplated copper. Because Sn is a soft material and has a low… Read More