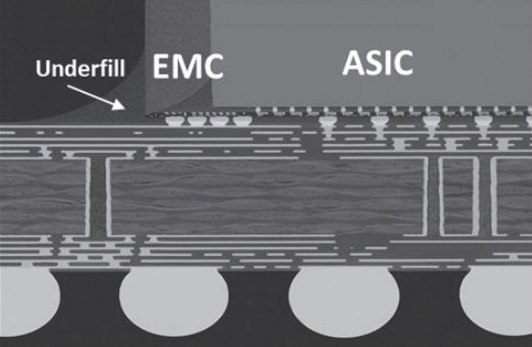
post
Fine-Line RDL Structure Analysis of Fan-Out Chip-on-Substrate Platform
The demand for high bandwidth memory (HBM) has driven the need for advanced packaging solutions, particularly those involving fan-out layers to interconnect wafers within packages. To meet the high-bandwidth requirements of the Fan-Out Chip-on-Substrate (FOCoS) technology platform, additional layers are required. However, as the number of fanout layers increases, significant… Read More