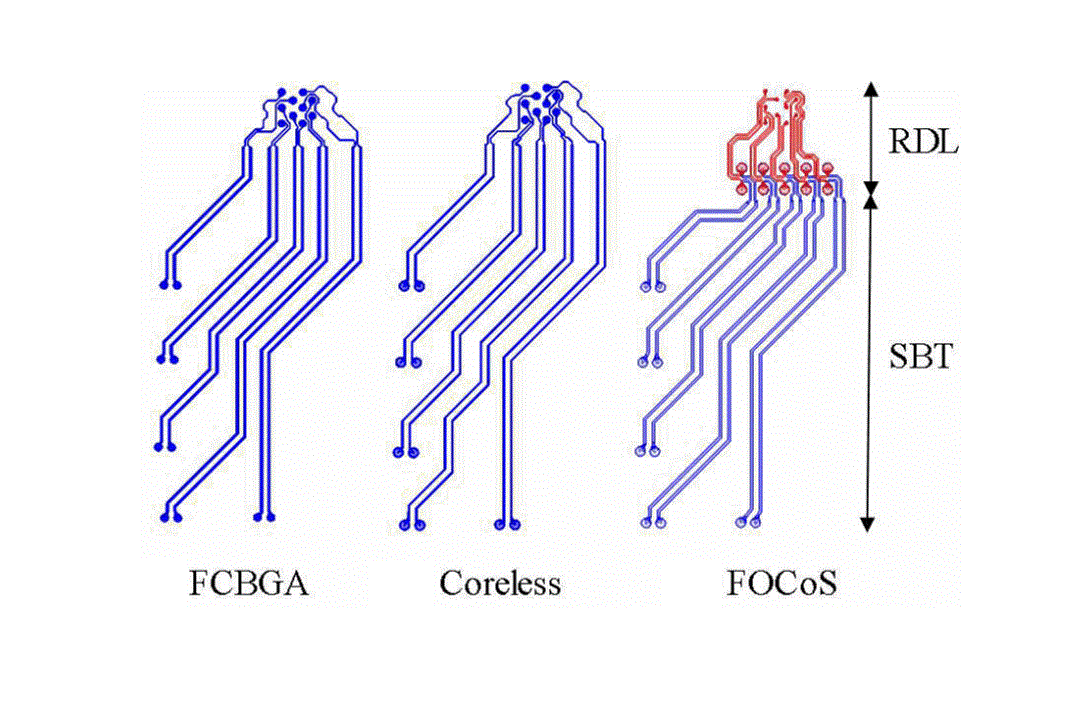
post
A Study on Alternative Substrate for FCBGA
As the increasingly demand of computer, communication and consumer electronics in recent years, flip-chip ball grid array (FCBGA) with ajinomoto build-up film (ABF) substrate is major package for performance request. But if we consider performance, substrate resource, and cost, alternative package structure is need to replace FCBGA. Hence, two alternative… Read More